結晶化率の測定方法及び測定装置
- 開放特許情報番号
- L2021000893
- 開放特許情報登録日
- 2021/7/7
- 最新更新日
- 2021/7/7
基本情報
| 出願番号 | 特願2006-336021 |
|---|---|
| 出願日 | 2006/12/13 |
| 出願人 | 国立大学法人東京農工大学 |
| 公開番号 | |
| 公開日 | 2008/6/26 |
| 登録番号 | |
| 特許権者 | 国立大学法人東京農工大学 |
| 発明の名称 | 結晶化率の測定方法及び測定装置 |
| 技術分野 | 電気・電子 |
| 機能 | 機械・部品の製造 |
| 適用製品 | 半導体薄膜の結晶化率の測定方法及び測定装置 |
| 目的 | 精度良く、かつ短時間に、半導体薄膜の結晶化率を測定する測定方法及び測定装置を提供する。 |
| 効果 | 透過光或いは反射光の光強度から、結晶化率を精度良く求めることができる。また、透過光或いは反射光の光強度から、簡便に短時間で、結晶化率を求めることができる。 |
技術概要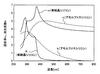 |
0〜1の範囲の数値であり、アモルファスの場合の結晶化率が0であり、単結晶の場合の結晶化率が1である、結晶化率を測定する方法であって、
基体上に形成された半導体薄膜に、単結晶の前記半導体薄膜の反射率が極大及び透過率が極小になる波長の光を照射し、 前記光の透過光の光強度、或いは、前記光の反射光の光強度を測定し、前記光強度の測定値と単結晶の前記半導体薄膜の当該波長における光強度の理論値との比と、下記の数式を使用して求めた結晶化率Xと透過率及び反射率との関係を使用して、前記半導体薄膜の結晶化率を算出する ことを特徴とする結晶化率の測定方法。 (式中、nは屈折率、kは消光係数、Xは結晶化率である。) |
| イメージ図 | |
| 実施実績 | 【試作】 |
| 許諾実績 | 【無】 |
| 特許権譲渡 | 【可】 |
| 特許権実施許諾 | 【可】 |
登録者情報
| 登録者名称 | |
|---|---|
その他の情報
| 関連特許 |
|
|---|

