| 出願番号 |
特願2014-163860 |
| 出願日 |
2014/8/11 |
| 出願人 |
日本放送協会 |
| 公開番号 |
特開2015-079938 |
| 公開日 |
2015/4/23 |
| 登録番号 |
特許第6389395号 |
| 特許権者 |
日本放送協会 |
| 発明の名称 |
欠陥密度測定装置及び欠陥密度測定プログラム |
| 技術分野 |
電気・電子 |
| 機能 |
機械・部品の製造、制御・ソフトウェア |
| 適用製品 |
半導体膜中の欠陥密度を測定する装置及びそのプログラム |
| 目的 |
酸化物半導体TFTのように、活性層中にキャリアを捕獲する欠陥を含む蓄積型の電界効果型の薄膜トランジスタに適用可能な、半導体膜中の欠陥密度の測定装置及び測定プログラムを提供する。 |
| 効果 |
酸化物半導体TFTのような、半導体膜中にキャリアを捕獲する欠陥を含む蓄積型の電界効果型の薄膜トランジスタについて、半導体膜中の欠陥密度の測定が可能となる。 |
技術概要
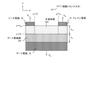 |
測定の対象が半導体膜中にキャリアを捕獲する欠陥を含む蓄積型の薄膜トランジスタであって、前記半導体膜と絶縁膜とゲート電極とをこの順で積層した構造を有する電界効果型の前記薄膜トランジスタについて、前記半導体膜中の欠陥密度を測定する欠陥密度測定装置。 |
| 実施実績 |
【無】 |
| 許諾実績 |
【無】 |
| 特許権譲渡 |
【否】
|
| 特許権実施許諾 |
【可】
|