| 出願番号 |
特願2009-067161 |
| 出願日 |
2009/3/19 |
| 出願人 |
独立行政法人産業技術総合研究所 |
| 公開番号 |
特開2010-219455 |
| 公開日 |
2010/9/30 |
| 登録番号 |
特許第5414036号 |
| 特許権者 |
国立研究開発法人産業技術総合研究所 |
| 発明の名称 |
絶縁ゲート型半導体装置の製造方法 |
| 技術分野 |
電気・電子、情報・通信、無機材料 |
| 機能 |
機械・部品の製造、材料・素材の製造、その他 |
| 適用製品 |
半導体装置 |
| 目的 |
この発明は、非ヒステリシストランジスタとヒステリシストランジスタとを混載する場合において、欠陥や不純物混入リスクの少ない良好な基板界面を保ったまま、同一材料の絶縁膜を用いて、ヒステリシストランジスタと非ヒステリシストランジスタとを同一基板上に混載することができる絶縁ゲート型半導体装置の製造方法を提供する。 |
| 効果 |
この発明の絶縁ゲート型半導体装置によれば、欠陥や不純物混入リスクの少ない良好な基板界面を保ったまま、同一材料の絶縁膜を用いて、ヒステリシストランジスタと非ヒステリシストランジスタとを同一基板上に混載することが可能となる。特に、トランジスタのゲート絶縁膜が基板外部から原料を基板上に付着させる方法により成膜される機能性材料である場合には、この発明の効果は高い。 |
技術概要
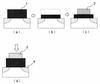 |
近年、トランジスタの微細化と高機能化を目的として、非ヒステリシストランジスタのゲート絶縁膜に例えばハフニウム(Hf)を主成分とする酸化物、Hfとアルミニウムを主成分とする酸化物、ランタンを主成分とする酸化物等の高誘電体材料を用い、ヒステリシストランジスタのゲート絶縁膜に前記の高誘電体材料を用いることが多くなっている。しかし従来の方法では非ヒステリシストランジスタとヒステリシストランジスタの相対的しきい値差の調整が難しくなる問題があった。 絶縁ゲート型半導体装置は、第1及び第2のトランジスタ形成領域上に第1のトランジスタにヒステリシス特性を与える絶縁膜を形成し、これを第1のトランジスタのゲート絶縁膜とする工程、及び、第2のトランジスタ形成領域上の絶縁膜を部分的にドライエッチング等によりエッチング除去することにより、第2のトランジスタにヒステリシス特性を与えない絶縁膜とし、これを第2のトランジスタのゲート絶縁膜とする工程を含む。この様に形成された素子は、強誘電体膜でありながら膜厚が小さくなるにしたがって非システリシス特性を有する膜に近い特性を有するものが得られる。 |
| イメージ図 |
|
| 実施実績 |
【無】 |
| 許諾実績 |
【無】 |
| 特許権譲渡 |
【否】
|
| 特許権実施許諾 |
【可】
|